이번 정리에서도 Package에서 Chip과 System이 결합할 때 가장 중요한 기술인 Bonding 기술에 대해서 설명드리고자 합니다. Bonding 기술 중에서 Soldering, 기타 Bonding에 대해서 다루고자 합니다.
1. Soldering
솔더를 퍼지게 해서 접합하는 방식, 우리가 흔히 알고 있는 용어인 납땜입니다. => 하지만 최근 납땜 불량 증가로 Soldering의 기술 발전이 필요합니다. 하지만 Soldering은 부품의 소형화 & 패키징 기술의 발전을 이끈 기술입니다.

- 방식
1. Wetting(Flux에 의해 Solder가 퍼져가며 접합하는 방식, Wetting Balance Test, Gloubule Method로 신뢰성을 평가)
2. Diffusion(Solder가 금속면에 잘 용해되게 만들어 줘 접합하는 방식)
솔더 종류: Bar Solder, Wire Solder, Paste Solder, Ball Solder, Type Solder
"최근 전자제품에 납을 사용할 수 없습니다. ROHS의 규격사에서 법안을 만들었는데, 인체에 좋지 않은 납 사용을 금지한 법안을 발표했기 때문입니다. 이로 인해 무해한 새로운 형태의 재료들이 등장하게 됩니다."
- 무연 솔더
무연 솔더는 환경에 무해하고, 적당한 Reflow의 온도로 접합할 수 있는 재료입니다. 주로 Wetting 방식을 사용해 접합하며, 기계적 강도가 좋으며, 가격이 저렴합니다.
무연솔더는 Wetting, 미세한 곳으로 스며드는 모세관 현상, Diffusion을 만족해야 합니다.
- Soldering 평가
[Wettability + Bondability = Solderability], Wetting과 접합강도가 솔더링의 성능을 나타내는 지표입니다.
Package 고려사항
재료 고려(Flux로 솔더링성을 높이고 산화막을 형성한다) => 설계 고려(Land, 도체(Cu), 부품, 리드, 기판, Via, Stack) => 솔더링 조건 고려(온도와 시간, 예열조건)
- Reflow Soldering
Solder를 공급해 놓고, 열을 가해 Soldering을 하는 방법(SMT 공정에 적합하다/ 열, Flux, Solder, 재료가 주요 고려사항)
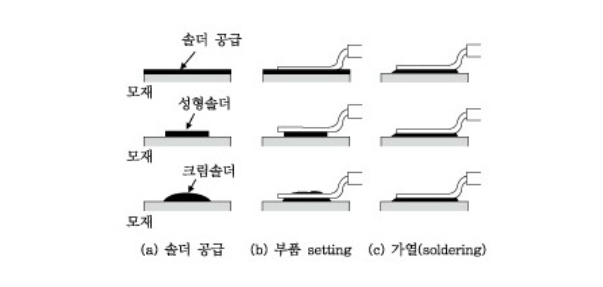
-Under Fill
Bump의 빈 공간을 채우는 공정, 기판간의 열팽창 차이를 감소시키며, 신뢰성을 향상시킬 수 있다. 또한, 기계적 결합 강도가 향상되어 응력이 증가하는 강점이 있다. Underfill을 주입하면서 빈공간이 생기는 Air Trapping 현상을 주의해야한다.

-Underfill 공정
1. Post-Assembly Underfill: CUF(컨밴셔널), MUF(중요, 하이닉스)
2. Pre-Assembly Underfill: NUF, NCP, NCF(중요, 삼성전자)

CUF는 가장 흔한 방법이며, 가격과 생산성에서 유리하다. Conventional Packge를 제작하는데 특화되어 있으며, 현업에서도 널리 사용되는 기술이다.
특히 NCF(비전도성 필름)는 Wafer 단위로 Underfill을 주입하기 때문에 Micro Bump를 이용해 제작하는데 용이하다. AVP가 중요한 시점에서 현업에서도 가장 널리 사용되는 기술이다. 특히 삼성전자가 TC-NCF를 사용하고 있다.
NCF 조건: 점도가 낮아야함, 경화시간이 낮아야함, 적절한 유리전이 온도, 높은 방열 특성, 내습성, 장치 신뢰성 확보
높은 방열 특성을 위해 무기필러를 장착하는데, 이는 점도가 높아지는 문제가 있어 Trade-off가 발생한다.
현재 가장 중요한 기술은 HBM에 사용된 TC-NCF와 MR-MUF 기술이다. MR-MUF 기술은 SK하이닉스가 HBM의 선발주자로 나아갈 수 있게 한 기술이며, 삼성도 TC-NCF기술로 SK하이닉스를 빠르게 따라잡고 있다.
하지만 문제는 발열과 수율이다. 하이닉스는 높은 기술력과 전문성을 바탕으로 HBM의 선두주자로 자리매김하였다.
삼성전자 또한, 이를 해결하고 HBM 시장에서도 우위를 점할 수 있기를 소망한다.
'반도체 패키지 > Advanced Package(AVP)' 카테고리의 다른 글
| HBM3E의 AP-FoM(TSMC) 기반 성능 평가 및 분석 (2) | 2024.06.16 |
|---|---|
| (삼성전자)HBM 16H Stacking을 위한 D2W HCB(하이브리드 본딩) (0) | 2024.06.13 |
| 표면실장 기술 - Bonding(Wire Bonding, Flip Chip Bonding) (0) | 2024.01.19 |
| 패키징(Packaging) 공정 프로세스 (0) | 2024.01.13 |
| Advanced Package(AVP) 기초 (0) | 2024.01.13 |



